- 高速、高可靠度薄膜量測,監測薄膜沉積與蝕刻製程
- 多波長量測不同材質、不同薄膜甚至透明薄膜及多層薄膜分析,不需耗費大量作業時間等候即可快速取得分析報告。
- 享單波長橢偏儀的價格,達全光譜橢偏儀的效能。

多波長優勢
- 量測透明薄膜厚度
- 其他參數量測,如:表面粗糙度、多層膜厚及分散係數
- 可連續監測參數,提供8種波長之分析報告參數分析,媲美光譜儀

[2024年升級版]
FS-8 高精準八波段橢偏儀
- 8個波長,光譜範圍:370 – 950 nm
- 可測量較厚的透明膜 (0-5μm),及吸收性半導體膜 (例如多晶矽,SiGe,非晶矽等)。
- 膜電阻率精準測量 (使用Drude模型)
- 多層膜堆疊精準測量
基本光學量測規格
| FS-4 經濟型四波段橢偏儀 | FS-8 高精度八波段橢偏儀 | ||
|---|---|---|---|
| 尺寸重量 | 主體 180 x 400 mm;5 kg | ||
| 光源 125 x 80 x 60 mm ; 檢測器 110 x 80 x 60 mm | |||
| 樣品尺寸 | 200 mm dia. | ||
| 光譜波段數 | 4個 | 8個 | |
| 光譜範圍 | 450-660nm | 370-950nm | |
| 光班尺寸 |
4 x 9 mm (可選配更小尺寸: 0.8 x 1.9 mm 或 0.25 x 0.55 mm)
|
||
| 特色 | 1. LED光源壽命長,減少更換頻率 2.電動光源偏光板可自動校正、區域內平均量測 (精準度高) 3.精度0.0004 nm 4.以乙太網路連結電腦與設備即可進入軟體資料 |
1. LED光源壽命長,減少更換頻率 2.電動光源偏光板可自動校正、區域內平均量測 (精準度高) 3.精度0.0004 nm 4.以乙太網路連結電腦與設備即可進入軟體資料 5.較長的735, 850, and 950 nm波長可量測較厚薄膜(up to 5μm) 並可吸收半導體膜(多矽晶、矽鍺、非晶矽) |
|
| 適用於 | 0-2μm單層透明膜量測 | 0-5μm單層透明膜量測/多層膜堆疊量測 | |
模型建立器 (Model Builder)
橢偏儀數據分析十分複雜,模型建立器是一個革命性的新功能,可以自動建立和測試分析模型。
- 易於使用且直觀:回答幾個簡單的問題來指定樣品的名義結構(基板和薄膜類型),模型建立器會:
- 建立和測試多個模型,從具有書面光學常數的簡單理想模型到具有表面粗糙度和分級的非理想模型。
- 建議如果模型擬合是可接受的,並推薦最適合樣品的“最佳”模型。
- 引導用戶檢查參數錯誤,驗證模型收斂,並保存模型 。
- 其他功能
- 自我記錄:懸停鼠標以查看各種設置和選項的詳細描述
- 實現高級分析功能,例如多樣本分析和參數化振蕩器模型
- 支持單點測量,自動映射和動態(原位)數據
- Film Sense將不斷發展和改進模型建立器,以支持更多類型的薄膜應用


分析軟體
- 軟體(微型電腦)架於探測器中,用戶操作介面為網頁瀏覽器,可支援瀏覽器(Windows、Mac OS X、Linux、iOS、Android)的PC、筆電或平板都可透過乙太網路連接來操作 Film Sense 橢偏儀。
- 主要優點是不需要安裝軟體,大大簡化了 Film Sense 橢偏儀的設置和操作。
- 亦可加購軟體桌面版以進行離線分析
軟體功能:
- 標準、原位多層、多樣本、軌跡和近表面數據分析模式。
- 多達 10 個模型層,可選擇表面粗糙度和基板背面校正。
- 參數範圍和起始增量可用於符合參數收斂
- 具溫度或成分相關的光學常數資料庫
- 去極化或透射強度數據可以與多波長數據分析相結合
- 可模擬單次測量或動態數據,並測試可信賴的差值及參數值
- 繪製擬合差異與 參數值。
- 數值符合90%信賴界線和相關矩陣,並可估計參數準確度。

The Single Measurement screen makes routine sample measurements as easy as clicking a button.
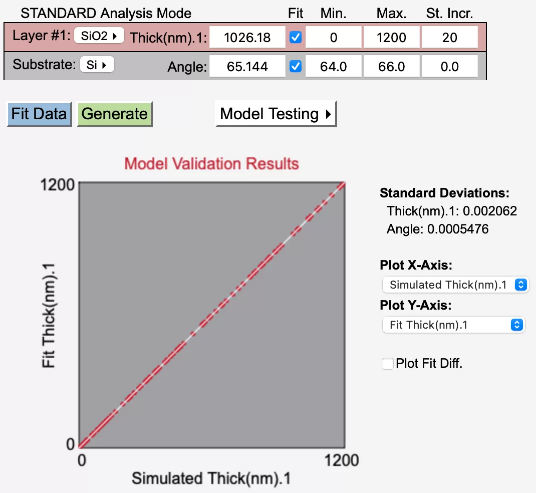
The Model Validator feature verifies that all model fit parameters will uniquely converge over the specified ranges.


