nXR-1
光譜干涉儀感應器
用於多層薄膜裝置的納米結構三維測量技術 光譜干涉方法的原理是通過一個分散元件結構來獲得光譜干涉信號,一次性獲取多層薄膜結構的表面形狀和多層薄膜的厚度的線條輪廓信息。 就水平分辨率而言,它由目標鏡頭的放大倍率確定,因此可以在比現有的反射率和橢圓度測量具有更高水平分辨率的情況下,以納米級精度測量多層薄膜的表面形狀。

產品特色

- 實時多層薄膜厚度和表面形狀測量
- 適用於測量半導體和顯示屏等多層薄膜結構

- 適用於大規模生產線
- 快速測量和資料獲取· 高精度

- 簡單的測量過程 · 多樣的數據分析
- 簡便的用戶界面
應用
3D 厚度資訊
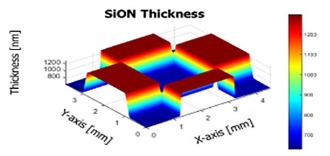
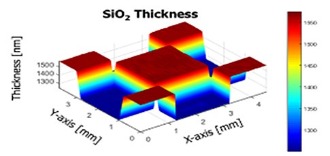
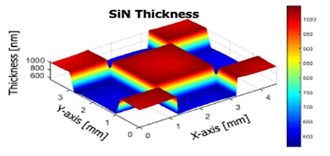
3D 厚度剖面
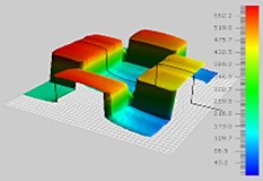
第三層:SiON 層
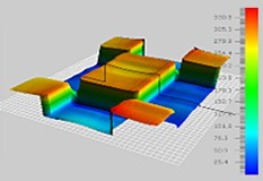
第二層:SiO₂ 層
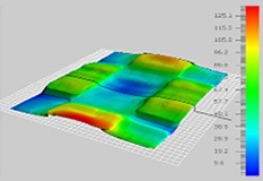
第一層:SiN 層

基板:矽(Si)
3D 厚度剖面